半导体封装是指将通过测试的晶圆按照产品型号及功能需求加工得到独立芯片的过程。封装过程为:来自晶圆前道工艺的晶圆通过划片工艺后被切割为小的晶片(Die),然后将切割好的晶片用胶水贴装到相应的基板(引线框架)架的小岛上,再利用超细的金属(金锡铜铝)导线或者导电性树脂将晶片的接合焊盘(Bond Pad)连接到基板的相应引脚(Lead),并构成所要求的电路;然后再对独立的晶片用塑料外壳加以封装保护,塑封之后还要进行一系列操作,封装完成后进行成品测试,通常经过入检Incoming、测试Test和包装Packing等工序,最后入库出货。
半导体封装一般用到点胶机+胶水环氧树脂,焊机+焊膏。典型的封装工艺流程为:划片、装片、键合、塑封、去飞边、电镀、打印 、切筋和成型 、外观检查、 成品测试 、包装出货。
半导体封装测试:
1、半导体生产流程由晶圆制造、晶圆测试、芯片封装和封装后测试组成。半导体封装测试是指将通过测试的晶圆按照产品型号及功能需求加工得到独立芯片的过程。
2、封装过程为:来自晶圆前道工艺的晶圆通过划片工艺后,被切割为小的晶片(Die),然后将切割好的晶片用胶水贴装到相应的基板(引线框架)架的小岛上,再利用超细的金属(金、锡、铜、铝)导线或者导电性树脂将晶片的接合焊盘(Bond
Pad)连接到基板的相应引脚(Lead),并构成所要求的电路;然后再对独立的晶片用塑料外壳加以封装保护,塑封之后,还要进行一系列操作,如后固化(Post Mold Cure)、切筋和成型(Trim&Form)、电镀(Plating)以及打印等工艺。封装完成后进行成品测试,通常经过入检(Incoming)、测试(Test)和包装(Packing)等工序,最后入库出货。典型的封装工艺流程为:划片→
装片→
键合→
塑封→
去飞边→
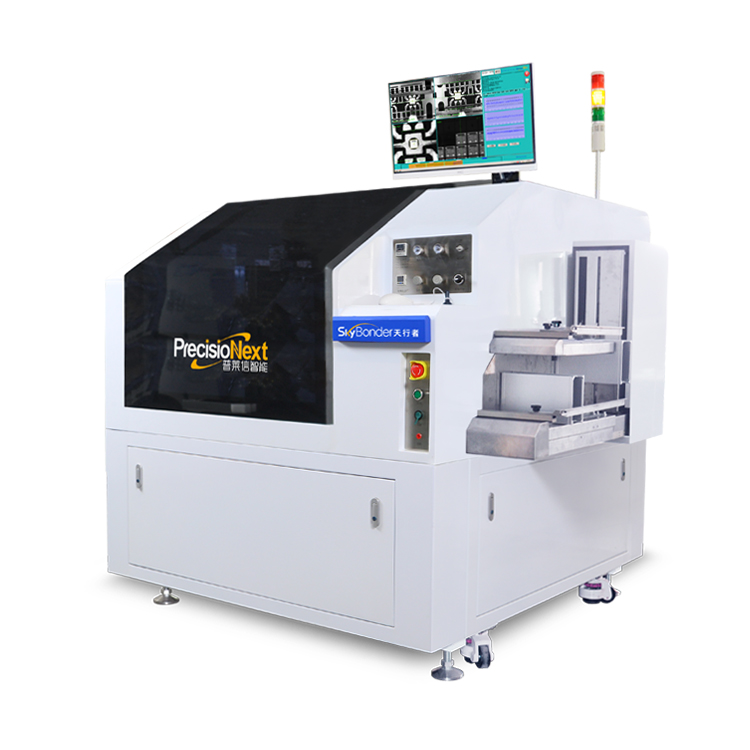
电镀
→打印→
切筋→成型→
外观检查→
成品测试→
包装出货。
3、半导体器件有许多封装形式,按封装的外形、尺寸、结构分类可分为引脚插入型、表面贴装型和高级封装三类。从DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技术指标一代比一代先进。总体说来,半导体封装经历了三次重大革新:第一次是在上世纪80年代从引脚插入式封装到表面贴片封装,它极大地提高了印刷电路板上的组装密度;第二次是在上世纪90年代球型矩阵封装的出现,满足了市场对高引脚的需求,改善了半导体器件的性能;芯片级封装、系统封装等是现在第三次革新的产物,其目的就是将封装面积减到最小。
4、半导体封装形式:金属封装、陶瓷封装、金属+陶瓷封装、塑料封装(最主要的封装形式)